Samsung s'apprête à introduire cette année des services de packaging 3D pour la mémoire à large bande passante (HBM), selon un rapport du Quotidien économique coréen qui cite l'annonce de l'entreprise lors du Samsung Foundry Forum 2024 à San Jose, ainsi que des « sources industrielles ». L'emballage 3D pour HBM ouvre essentiellement la voie à HBM4 l’intégration est prévue fin 2025 – 2026, mais nous ne savons pas quel type de mémoire Samsung est prêt à proposer cette année.
Pour le packaging 3D, Samsung dispose d'une plate-forme appelée SAINT (Samsung Advanced Interconnect Technology) qui comprend trois technologies d'empilement 3D distinctes : SAINT-S pour SRAM, SAINT-L pour la logique et SAINT-D pour l'empilement de DRAM sur des puces logiques comme Processeurs ou GPU. L'entreprise travaille sur SAINT-D depuis plusieurs années (et officiellement l'a annoncé en 2022) et il semble que la technologie sera prête à être diffusée aux heures de grande écoute cette année, ce qui constituera une étape importante pour le plus grand fabricant de mémoires au monde et une fonderie leader.
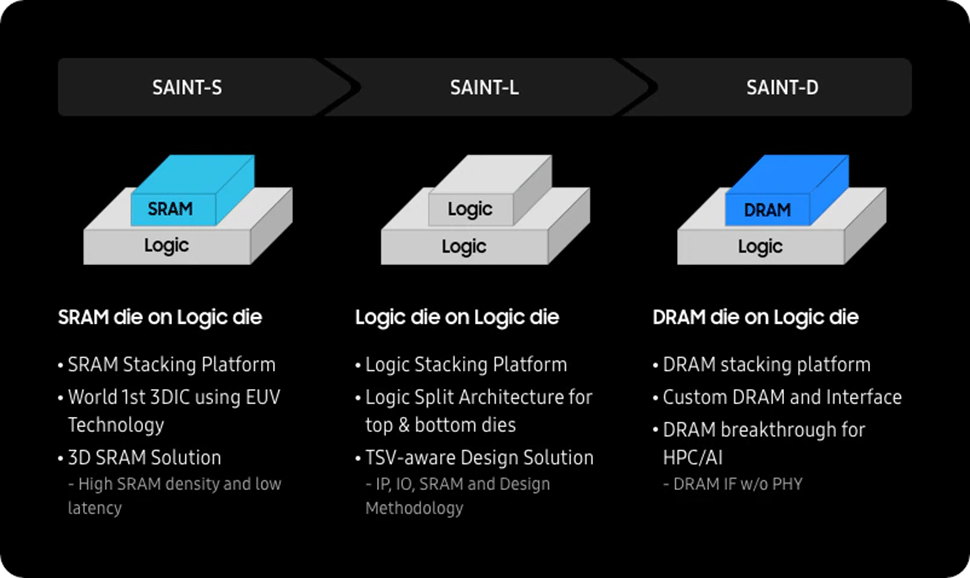
La nouvelle méthode d'emballage 3D de Samsung consiste à empiler les puces HBM verticalement sur les processeurs, ce qui diffère de l'existant. Technologie 2.5Dy qui connecte les puces HBM et les GPU horizontalement via un interposeur en silicium. Cette approche d'empilement vertical élimine le besoin d'un interposeur en silicium mais nécessite une nouvelle puce de base pour la mémoire HBM fabriquée à l'aide d'une technologie de processus sophistiquée.
La technologie de packaging 3D offre des avantages significatifs pour HBM, notamment des transferts de données plus rapides, des signaux plus propres, une consommation d'énergie réduite et des latences plus faibles, mais à des coûts de packaging relativement élevés. Samsung prévoit de proposer cet emballage HBM 3D avancé sous la forme d'un service clé en main, dans lequel sa division mémoire produit des puces HBM et l'unité de fonderie assemble de véritables processeurs pour les entreprises sans usine.
Ce qui reste flou, c'est exactement ce que Samsung prévoit de proposer avec SAINT-D cette année. Mettre HBM sur une puce logique nécessite une conception de puce appropriée et nous ne connaissons aucun processeur d'entreprises bien connues conçu pour maintenir HBM au sommet et dont le lancement est prévu entre 2024 et 1S 2025.

Pour l’avenir, Samsung vise à introduire une technologie d’intégration hétérogène tout-en-un d’ici 2027. Cette future technologie permettra l’intégration de deux couches de puces logiques, de mémoire HBM (sur interposeur) et même d’optiques co-packages (CPO).
->Google Actualités










